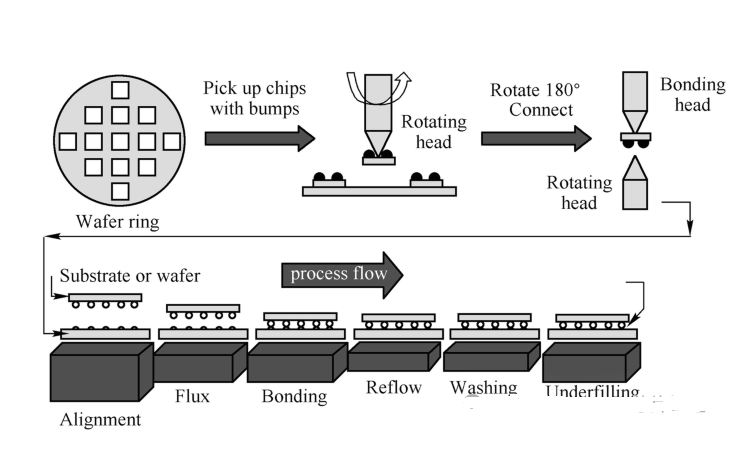
Позвольте ’ продолжить изучение процесса установки чипа.
Как показано на обложке.
1. Сбор стружки с выступами:
На этом этапе пластина разрезается на отдельные чипы, наклеенные на синюю пленку или УФ-пленку. Когда требуется подхват фишки, штифты выдвигаются снизу, аккуратно надавливая на заднюю часть фишки, слегка приподнимая ее. В то же время вакуумная насадка аккуратно подхватывает стружку сверху, отделяя ее от синей пленки или УФ-пленки.
2. Ориентация стружки:
После того, как стружка захватывается вакуумным соплом, она передается к склеивающей головке, и во время передачи ориентация стружки меняется так, чтобы сторона с выступами была обращена вниз, готов к выравниванию с подложкой.
3. Выравнивание стружки:
Выступы повернутой стружки точно совпадают с площадками на упаковочной подложке. Точность выравнивания имеет решающее значение для обеспечения точного совмещения каждого выступа с положением площадки на подложке. На контактные площадки на подложке наносится флюс, который служит для очистки, уменьшения поверхностного натяжения шариков припоя и улучшения растекания припоя.
4. Склеивание стружки:
После выравнивания чип аккуратно помещается на подложку с помощью связующей головки, после чего применяется давление, температура и ультразвуковая вибрация, в результате чего шарики припоя оседают на подложке, но эта первоначальная связь не является сильной.
5. Перекомпоновка:
Высокая температура процесса пайки оплавлением плавит и растекает шарики припоя, создавая более плотный физический контакт между выступами чипа и контактными площадками подложки. Температурный профиль пайки оплавлением состоит из стадий предварительного нагрева, выдержки, оплавления и охлаждения. При понижении температуры расплавленные шарики припоя вновь затвердевают, значительно укрепляя связь между шариками припоя и контактными площадками подложки.
6. Мойка:
После завершения пайки оплавлением на поверхностях чипа и подложки останется остаточный флюс. Поэтому для удаления остатков флюса необходимо специальное чистящее средство.
7. Недосыпка:
Эпоксидная смола или аналогичный материал впрыскивается в зазор между чипом и подложкой. Эпоксидная смола в первую очередь действует как буфер, предотвращающий появление трещин на неровностях из-за чрезмерного напряжения во время последующего использования.
8. Молдинг:
После отверждения герметизирующего материала при соответствующей температуре выполняется процесс формования, за которым следуют испытания на надежность и другие проверки, завершающие весь процесс герметизации чипа.
Это вся информация о флип-чипе в технике SMT. Если вы хотите узнать больше, просто сделайте заказ у нас.

 русский
русский English
English Español
Español Português
Português français
français 日本語
日本語 Deutsch
Deutsch Tiếng Việt
Tiếng Việt Italiano
Italiano Nederlands
Nederlands ไทย
ไทย Polski
Polski 한국어
한국어 Svenska
Svenska magyar
magyar Malay
Malay বাংলা
বাংলা Dansk
Dansk Suomi
Suomi हिन्दी
हिन्दी Pilipino
Pilipino Türk
Türk Gaeilge
Gaeilge عربى
عربى Indonesia
Indonesia norsk
norsk اردو
اردو čeština
čeština Ελληνικά
Ελληνικά Українська
Українська Javanese
Javanese فارسی
فارسی தமிழ்
தமிழ் తెలుగు
తెలుగు नेपाली
नेपाली Burmese
Burmese български
български ລາວ
ລາວ Latine
Latine Қазақ
Қазақ Euskal
Euskal Azərbaycan
Azərbaycan slovenský
slovenský Македонски
Македонски Lietuvos
Lietuvos Eesti Keel
Eesti Keel Română
Română Slovenski
Slovenski मराठी
मराठी Српски
Српски 简体中文
简体中文 Esperanto
Esperanto Afrikaans
Afrikaans Català
Català עִברִית
עִברִית Cymraeg
Cymraeg Galego
Galego 繁体中文
繁体中文 Latvietis
Latvietis icelandic
icelandic יידיש
יידיש Беларус
Беларус Hrvatski
Hrvatski Kreyòl ayisyen
Kreyòl ayisyen Shqiptar
Shqiptar Malti
Malti lugha ya Kiswahili
lugha ya Kiswahili አማርኛ
አማርኛ Bosanski
Bosanski Frysk
Frysk ជនជាតិខ្មែរ
ជនជាតិខ្មែរ ქართული
ქართული ગુજરાતી
ગુજરાતી Hausa
Hausa Кыргыз тили
Кыргыз тили ಕನ್ನಡ
ಕನ್ನಡ Corsa
Corsa Kurdî
Kurdî മലയാളം
മലയാളം Maori
Maori Монгол хэл
Монгол хэл Hmong
Hmong IsiXhosa
IsiXhosa Zulu
Zulu Punjabi
Punjabi پښتو
پښتو Chichewa
Chichewa Samoa
Samoa Sesotho
Sesotho සිංහල
සිංහල Gàidhlig
Gàidhlig Cebuano
Cebuano Somali
Somali Точик
Точик O'zbek
O'zbek Hawaiian
Hawaiian سنڌي
سنڌي Shinra
Shinra հայերեն
հայերեն Igbo
Igbo Sundanese
Sundanese Lëtzebuergesch
Lëtzebuergesch Malagasy
Malagasy Yoruba
Yoruba